
KRi 霍尔离子源典型应用溅镀镀膜预清洁工艺 Pre-clean
上海伯东美国 KRi 霍尔离子源 EH 400F 成功应用于 6寸硅片电源管理集成电路芯片 PMIC 溅镀镀膜前预清洁工艺 Pre-clean.
电源管理集成电路芯片镀膜时常用的材料, 例如: 铌酸锂 LiNbO3 , 钛酸钡 BaTi03 , 锆钛酸铅 PTZ, 氧化锌 ZnO , 氮化铝 AiN … 膜层与硅片会有脱膜及电性阻抗问题. 美国 KRI 霍尔离子源有最高广角的涵盖面积 >45゚, 及高解离率获得高密度的离子浓度, 在电源管理集成电路芯片 PMIC 的压电材料镀膜前有效的将硅片做清洁及平整化处理, 提高膜层的附着力及提高生产良率.
电源管理集成电路芯片 PMIC 溅镀镀膜前预清洁工艺
设备: 5只靶材复合性溅镀机
基材: 6 存硅片
真空系统: 上海伯东美国 HVA 高真空插板阀 + 伯东 Pfeiffer 全磁浮分子泵
KRi 霍尔离子源: EH 400F
预清洁工艺离子源条件: Vd:120V (离子束阳极电压), Id:3.5A (离子束阳极电流), Ar gas: 20sccm (氩气).
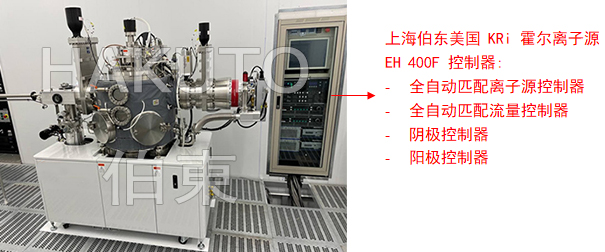
 腔体中 KRi 霍尔离子源 EH 400 本体, 工作條件: Vd:120V, Id:3.5A, Ar:20sccm
腔体中 KRi 霍尔离子源 EH 400 本体, 工作條件: Vd:120V, Id:3.5A, Ar:20sccm
上海伯东美国 KRi 霍尔源可依客户镀膜机尺寸, 基材尺寸, 工艺条件选择适合型号
|
型号 |
eH400 |
eH1000 |
eH2000 |
eH3000 |
|
中和器 |
F or HC |
F or HC |
F or HC |
F or HC |
|
离子束阳极电压 |
50-300 V |
50-300 V |
50-300 V |
50-250 V |
|
离子束阳极电流 |
5A |
10A |
10A |
20A |
|
散射角度 |
>45 |
>45 |
>45 |
>45 |
|
气体流量 |
2-25 sccm |
2-50 sccm |
2-75 sccm |
5-100 sccm |
|
本体高度 |
3.0“ |
4.0“ |
4.0“ |
6.0“ |
|
直径 |
3.7“ |
5.7“ |
5.7“ |
9.7“ |
|
水冷 |
可选 |
可选 |
是 |
可选 |
F = Filament; HC = Hollow Cathode;
1978 年 Dr. Kaufman 博士在美国创立 Kaufman & Robinson, Inc 公司, 研发生产考夫曼离子源, 霍尔离子源和射频离子源. 美国考夫曼离子源历经 40 年改良及发展已取得多项专利. KRi 离子源广泛用于离子清洗 PC, 离子蚀刻 IBE, 辅助镀膜 IBAD, 离子溅射镀膜 IBSD 领域, 上海伯东是美国考夫曼离子源中国总代理.
若您需要进一步的了解产品详细信息或讨论, 请联络上海伯东邓女士, 分机134









